對于
COB光源接下來的發展,首先是在確保產品性能的前提下,將規模提上去、價格降下來;其次是從小功率向中、大功率發展;最后是結合
COB光源的特性,配套研發更多的燈具,讓
COB光源更充分發揮其作用。自2013以來,西鐵城、夏普、philipslumileds、首爾半導體、cree等國際大廠相繼在中國市場推出高光效、高品質、高效率的cob新品。高光效led集成燈珠2)采用ASM的焊線設備將晶片11與基板12過導電線13進行電性連接,使晶片11與基板12上的電路實現導通,焊接完成后,對產品進行檢測,不合格的產品重新返修,合格的產品轉入下一道工序;3)在基板12上設置第一層圍壩14,晶片11及導電線13處于第一層圍壩14所包圍的區域內,將設置好第一層圍壩14的基板12放進烤箱進行烘烤,待第一層圍壩14固化后取出高光效led集成燈珠
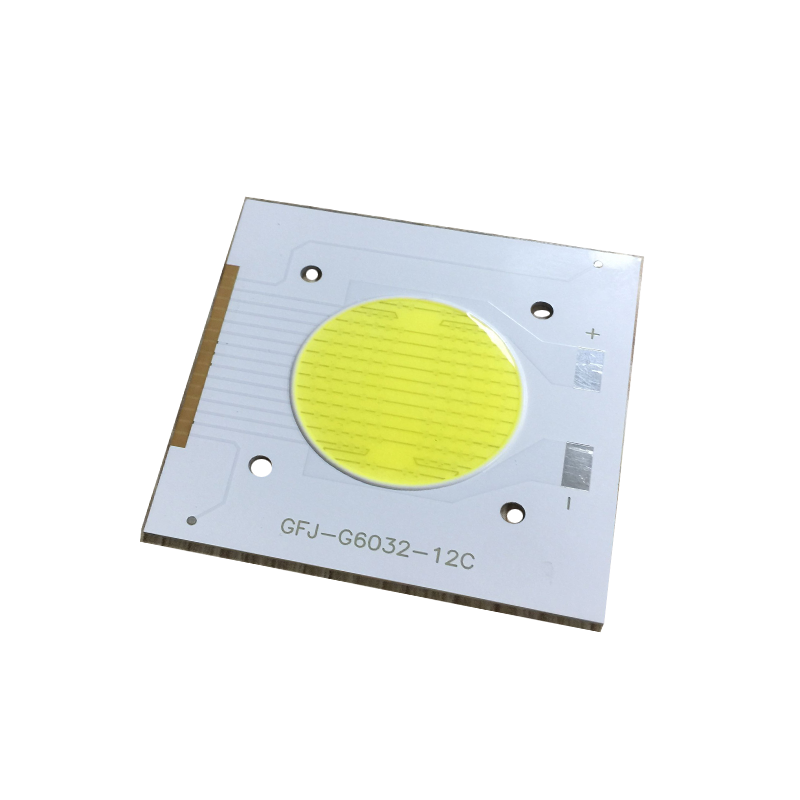
與SMD貼片相比,具有五點明顯優勢:一、COB在光學配光方面是其它光源無法比擬的;二、
COB光源在結構應用中空間大,更符合商照結構要求;三、合理的封裝形式可以讓芯片充分散熱,保證芯片質量和壽命;四、出光面一致性好,無色斑;五、模組化,應用可直接安裝使用,無須另外考慮工藝設計。。當然,亦可以采用自然固化的方法使第一層圍壩14固化;在第一層圍壩14上設置第二層圍壩15,將設置好第二層圍壩15的基板12放進烤箱進行烘烤,待第二層圍壩15固化后取出,亦可以采用自然固化的方法使第二層圍壩15固化,此時第一層圍壩14以及第二層圍壩15形成整體式的整體圍壩。根據實際需要,可在第二層圍壩15上設置繼續設置圍壩,這樣形成整體圍壩的層數更多,使得整體圍壩的高度更高,設置圍壩的目的是為了后面的封膠做準備,而設置多層的整體圍壩是為了增加圍壩的高度,亦可用其他方法增加圍壩的高度,如優化圍壩設備等;裸芯片技術主要有兩種形式:一種COB技術,另一種是倒裝片技術(FlipChip)。板上芯片封裝(COB),半導體芯片交接貼裝在印刷線路板上,芯片與基板的電氣連接用引線縫合方法實現,并用樹脂覆蓋以確保可靠性。
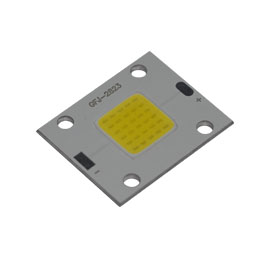
高光效led集成燈珠2015年,COB再次“火”了起來。如果說COB的前兩次發展推動了LED行業,那么這次純粹就是為了與舊傳統“接軌”,本質上是一種倒退。誠然,COB是解決了“鬼影”問題,可是此前的發展證明COB在這方面是弊大于利的其中P(T)為輻射能量,σ為斯特藩—玻耳茲曼常量,ε為發射率,紅外測溫的精確與待測材料的發射率密切相關,由于
COB光源表面的大部分材料發射率是未知的,為了精準測溫,可將光源放置在恒溫加熱臺上,待光源加熱到一個已知溫度處于熱平衡狀態后,用紅外熱成像儀測量物體表面溫度,再調整材料的發射率,使其溫度顯示為正確溫度。。雖然燈珠性能的大幅提升為COB封裝創造了良好的技術基礎,使其終于滿足了市場的應用需求。這一切看上去很美好,但是COB產品形態的底層邏輯問題,使得再好的技術也彌補不了自身缺陷。而且正是基于良好技術在客觀上的誘使,導致對LED特性不熟悉的設計者在錯誤的道路上越滾越遠。

高光效led集成燈珠COB與傳統LEDSMD比較背景:LED自進入照明領域,最初形式是燈珠直接焊接在板上,先3528,5050,再后來3014,2835高光效led集成燈珠2、發光面溫度實測為進一步從實驗上研究
COB光源的熱分布,選用我司14年主推的一款定型產品作為實驗研究對象,該款光源選用是的高反射率鏡面鋁為基板,這種封裝結構一方面可大幅提高出光效率,另一方面封裝形式采用熱電分離的形式,沒有普通鋁基板的絕緣層作為阻攔,可進一步降低熱阻和結溫,實現
COB光源高光通量密度輸出。。但這種方式的弊端是工序繁多,又是LED封裝又是SMT,成本高,更有傳熱等問題。所以COB在這個時候被引進了LED領域。